FC-BGA 대면적화
FC-BGA는 전통적으로 CPU, GPU, FPGA(Field Programmable Gate Array), ASIC 등 고성능 프로 세서를 위해 쓰인다. 이들 프로세서는 주로 DRAM, 칩셋 등과 함께 패키지된다. 또한 최근에는 모듈형 디자인 형태의 칩렛(Chiplet)의 활용이 늘어나는 추세다. 이 때문에 FC-BGA도 멀티칩 모듈화(MCM)되 고 있고, Die간 고속 상호연결 기술에 대한 요구가 늘어나고 있다.
FC-BGA의 패키지 크기는 20~80㎜이고, 기판 층수는 6층에서 22층까지 확대됐다. 더 촘촘한 간격의 Flip chip Bump를 구현하는 방향으로 진화하고 있다. 대체로 10층 미만이지만, 최근 24층(11-2-11) 구조까지 고도화됐다. 2018년만 해도 9-2-9 구조가 최상이었다.

고성능 프로세서가 대면적 FC-BGA 요구
대면적 FC-BGA는 고성능 컴퓨팅, 데이터 서버, 통신에 사용되는 고성능 CPU, GPU, 스위치 등에 채용된다. 클라우드 컴퓨팅, 인공지능, 고속 통신 트렌드를 위한 필요하다.
이러한 고성능 프로세서는 200㎟ 이상의 대면적 Die와 1,000~10,000개에 이르는 많은 I/O를 가지며, 최적의 성능을 위해 메모리나 다른 프로세서와 함께 패키지 되기도 한다. 이들은 또다른 대면적, 고난도 패키지와 멀티칩 모듈을 요구하기도 하고, 비싼 패키지 기판을 사용한다.
FC-BGA 크기가 2배, 3배로 커지면 면적은 4배, 9배로 커진다.

대면적 FC-BGA 사례
대면적 FC-BGA의 대표적 사례로서 AMD의 Zen 2 서버 프로세서와 Intel의 Xeon 서버 CPU가 있다. 두 제품의 FC-BGA 크기는 각각 75.4x58.5㎜, 76.0x56.5㎜에 달한다. AMD의 Zen 2 서버 프로세서는 여러 개의 대형 Die를 통합했고, 20층(9-2-9) 구조에 회로선폭은 12㎛를 구현했다. 이 외에도 Intel Xeon Platinum 9200 CPU용 FC-BGA 크기는 72.5x76.0㎜, HiSilicon HI1620 서버 프로세서용 FC-BGA 크기는 60x75㎜다.

서버용이 고사양, 대면적
서버용 FC-BGA가 더욱 대면적이고, 더욱 복잡하며, I/O가 많다. 층수면에서 노트북용이 10층이라면, 서버용은 16~18층이다. 면적의 경우 노트북용이 대략 37x37㎜라 면, 서버용은 50x50㎜, 60x60㎜ 수준이다. PC용은 박판이고, 서버용은 후판이다.
물론 서버가 노트북보다 공간 제약이 덜하기 때문에 대면적, 후판에 관대하다. 또한 Intel은 서버 CPU의 경우 현장 업그레이드를 위해 소켓을 사용하는데, 이 소켓이 대면적의 원인이 된 다. 이전 버전과의 호환성을 고려해야 하기 때문에 작은 패키지로 이동하기 어렵다. 이로 인해 서버용 FC-BGA의 판가가 PC용에 비해 평균 2~3배 비싸고, 서버용 FC-BGA의 생산능력 잠식 효과가 매우 크다.

앞서 언급한 Intel의 Xeon 서버 CPU 패키지를 구체적으로 살펴보면, 크기가 노트북 CPU 패키지보다 3 배 이상 크다. Intel은 서버 CPU 제품에 PoINT(Patch on Interposer) 패키지 기술을 채용했다. 이름에 서 보듯이 인터포저 위에 패치를 붙이는 방식이다. 즉 ① 먼저 CPU를 작고, 밀도가 높은 패치 위에 실장하고, ② 이 패치를 다시 더 크고, 밀도가 낮은 인터포저 위에 실장한다. 패치와 인터포저 모두 FCBGA 기판이다.

Intel의 Xeon 서버 CPU의 경우 인터포저는 76.0x56.5㎜ 크기 12층 구조 FC-BGA이고, CPU를 실장 한 패치는 35.0x37.5㎜ 크기 18층(8-2-8) 구조 FC-BGA다. 이러한 고밀도 기술을 바탕으로 140㎛ 플립 칩 범프 피치와 0.35㎜ BGA 볼 피치를 구현했다.
Apple, 독창적 패키지 기술 도입
Apple은 새로운 M1 프로세서를 통해 프로세서와 메모리를 함께 패키징하는 기술을 채용했다. M1 프로세서는 Apple의 독창적인 시스템 아키텍처에 최적화된 구조이며, Apple의 모든 노트북과 데스크톱 에 적용할 예정이다. 프로세서와 DRAM 메모리를 통합하면 확실시 성능 개선에 도움이 된다.
M1은 TSMC의 최신 5nm 노드 공정을 활용해 제작됐고, 크기, 성능, 전력 효율성 면에서 장점을 가진 다. 그러다 보니 2개의 DDR4 DRAM을 적층하고도 23x27㎜의 상당히 작은 사이즈로 구현했다. M1 프로세서와 DRAM 패키지가 실장된 FC-BGA는 3-2-3층 구조에 35㎛ L/S로 구현됐다. 이러한 신형 FC-BGA의 공급 능력을 갖춘 업체는 Ibiden, 삼성전기, Unimicron에 국한될 것이다.

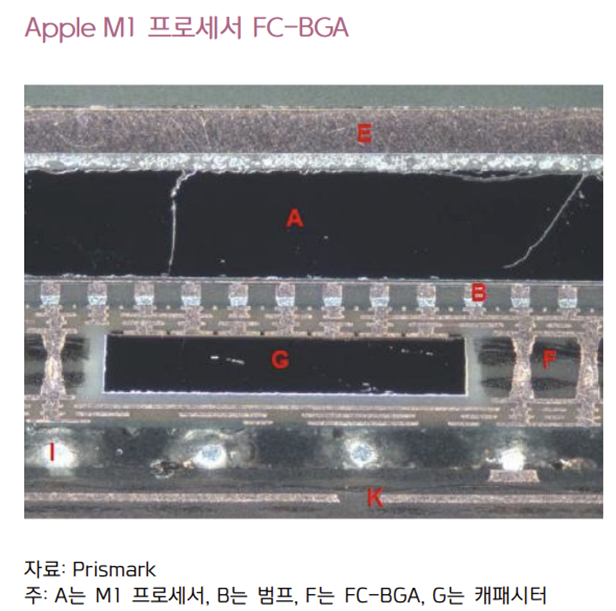
출처: Prismark, 키움증권, AMD
뜨리스땅
https://tristanchoi.tistory.com/268
전자부품 기업 탐구: 패키지 기판 기업 update
2022년에도 부품 대장은 기판 기판은 수요 Peak-out 환경에서도 상대적으로 가장 견조한 부품일 것이다. 1. 패키징기판: ‘수요 감소’보다 ‘수급 괴리’ 수요 불확실성에도 패키징기판은 가장 견
tristanchoi.tistory.com
'반도체, 소.부.장.' 카테고리의 다른 글
| 반도체 기술 탐구: 자동차용 전력 반도체 (0) | 2022.06.26 |
|---|---|
| 반도체 기술 탐구: DDR5 출시에 따른 Value Chain 업데이트 (0) | 2022.05.13 |
| 반도체 기술 탐구: 차세대 패키지 기술 종합 3 - 기타기술 (0) | 2022.05.10 |
| 반도체 기술 탐구: 차세대 패키지 기술 종합 2(인터포저란 무엇인가?) (0) | 2022.05.10 |
| 반도체 기술 탐구: 5G와 패키지 기판 (0) | 2022.05.09 |




댓글