1. 기업 개요
1989년 설립된 이후 약 35년간 레이저를 활용한 장비를 반도체, 디스플레이, PCB 등 다양한 전방 산업에 공급해왔다. 반도체향 Marker, Annealing, Cutting (Grooving, Stealth Dicing, Full-Cutting), PCB향 Driller, 디스플레이향 LLO, PI Glass Cut, 2차전지향 Macro 장비를 생산 중이다.
2023년 부문별 매출 비중은 반도체 46%, PCB 13%, 디스플레이 12%, Macro(2차전지) 3% 수준으로 판단되며, 반도체 부문에서 글로벌 비메모리, 메모리, OSAT 업체를 고객사로 확보했다.

Marker
1) PKG가 진행되지 않은 칩, 2) 테스트까지 완료된 반도체 완제품(패키지, 모듈) 에 제조사, 제품명 등 다양한 정보를 기록하는 공정이다. 반도체 칩 또는 PKG가 완료된 완제품에서 불량이 발생할 경우 마킹된 정보를 통해서 추적하는데 용이 한 장점을 갖고 있다. 과거에는 잉크 마킹 기술을 통해서 공정이 진행됐다.
하지만 1) 소모품 비용 ↓, 2) 공정 소요 시간 ↓, 3) 취급 난이도 ↓, 4) 환경 문제 ↓ 이유로 2000년대부터 레이저 마킹 장비로 대체되기 시작했다.

Annealing
어닐링은 격자 배열이 파괴된 웨이퍼에 열을 가하여 격자 배열을 재결정해주는 공정이다. 격자가 손상된 상태에서는 자유원자가 발생하여 다른 원자와 계속 충돌하며 손상을 유발하기 때문에 복원(재결정화) 과정이 요구된다. 웨이퍼 표면에 고온(500~1000도)의 열을 가한 후 냉각시키는 방식으로 진행된다. 과거에는 퍼니스 및 RTA 방식을 주로 사용했지만, 공정미세화에 따라 레이저 어닐링 공정 도입이 확대되고 있다.


Dicing
다이싱(Dicing) 공정은 웨이퍼에 만들어진 반도체를 개별 칩으로 분리해주는 공 정을 의미한다. Laser 방식과 Mechanical 방식이 있으며, 반도체 미세화에 따라 Laser Dicing 공정 방식이 확대되고 있다. 기존의 다이싱 공정의 주된 방식인 Mechanical Dicing은 웨이퍼에 물리적인 힘을 가하기 때문에 칩핑(Chipping, 칩 가장자리 깨짐), 크랙(Crack, 칩 깨짐) 등과 같은 결함에 취약했다.

레이저 그루빙은 칩 분리 이전에 홈을 만들때 레이저 기술을 활용하는 공정이다. 스크라이브 라인 내 TEG 영역, Low-K막, 구리 등 메탈 부분을 제거한다. 블레 이드 휠이 아닌 레이저를 통해서 홈을 만들기 때문에 추후 Mechanical Sawing에 서 발생한 침핑, 크랙, 가공 품질 문제를 일부 개선할 수 있다는 장점이 있다.
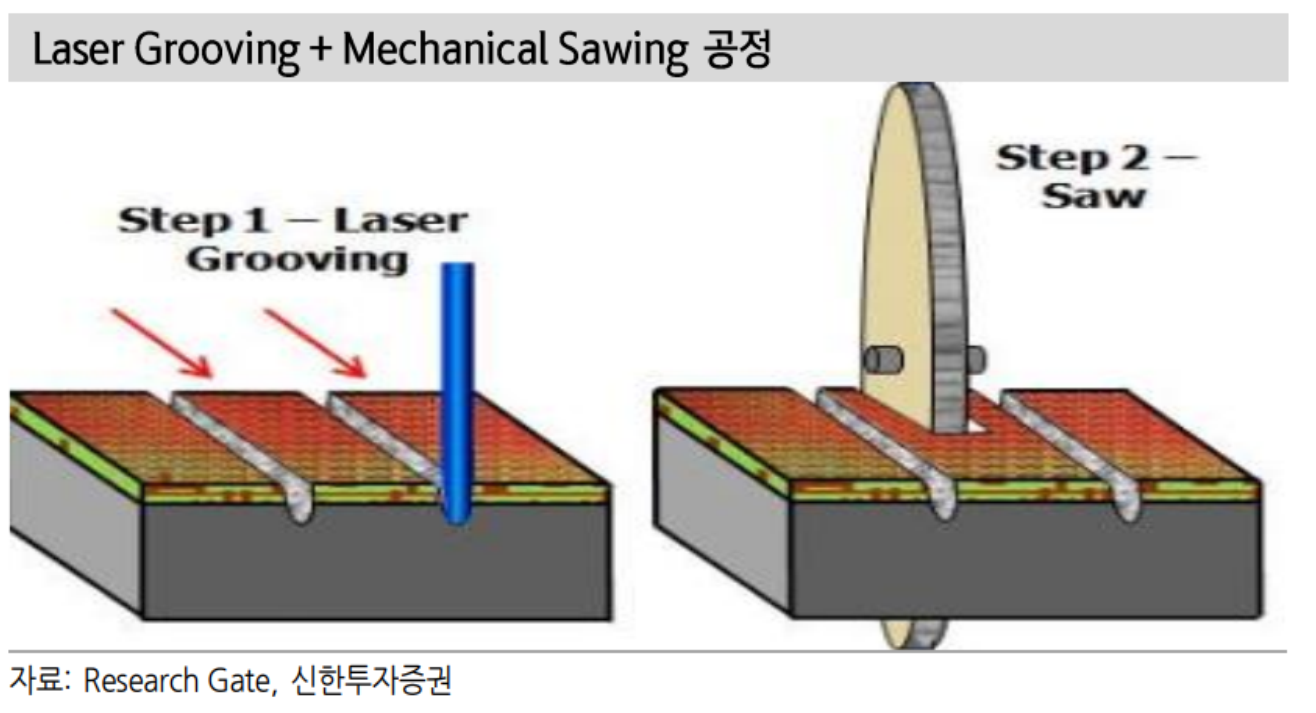
스텔스 다이싱은 웨이퍼에 레이저를 조사하여 표면을 직접 절삭하는 기술이다. 레이저 에너지를 통해 웨이퍼 내부에 균열을 만들어 다이싱을 하기 때문에 손상을 최소화하는 장점이 있다. 기존의 방식은 물리적인 충격을 가하기 때문에 웨이퍼 전면에 실리콘 부스러기가 붙어, 이를 제거하는 공정이 요구된다.
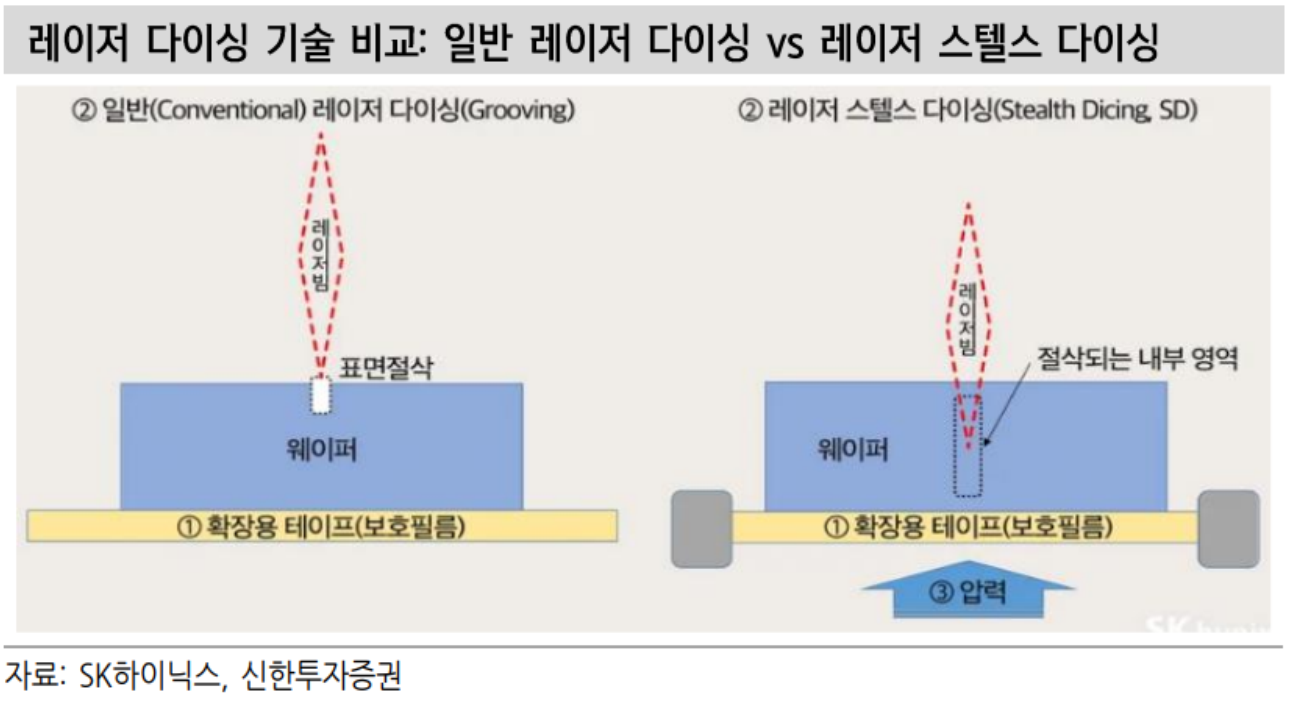
레이저 풀커팅은 블레이드 휠, Expansion Tape 등을 활용하지 않고 오로지 레이 저 기술만을 활용하여 칩을 분리시킬 수 있다. 레이저를 1회 또는 여러 차례 조 사하여 웨이퍼를 개별 칩으로 만들어주는 공정이다.
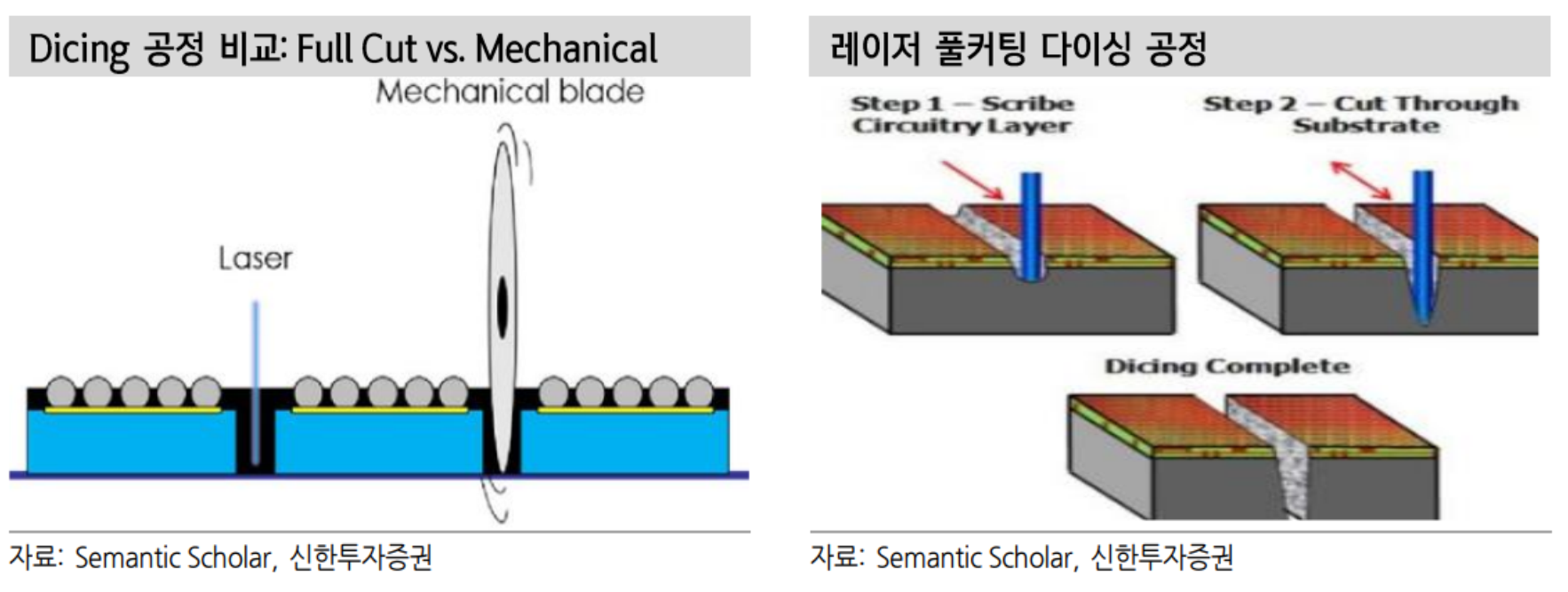
Drill 공정
드릴공정은 말 그대로 구멍을 만들어주는 공정이다. PCB기판에 Via(구멍)를 뚫어 기판 내에 있는 여러 개의 레이어간 신호 전달 연결을 가능하게 한다. 반도체 미세화와 함께 반도체 I/O 단자가 많아졌고, PCB기판에도 더 많은 Via가 요구되고 있는 환경이다. 이에 반도체와 마찬가지로 PCB기판에도 더 작고 많은 Via를 만 들어 줘야한다.
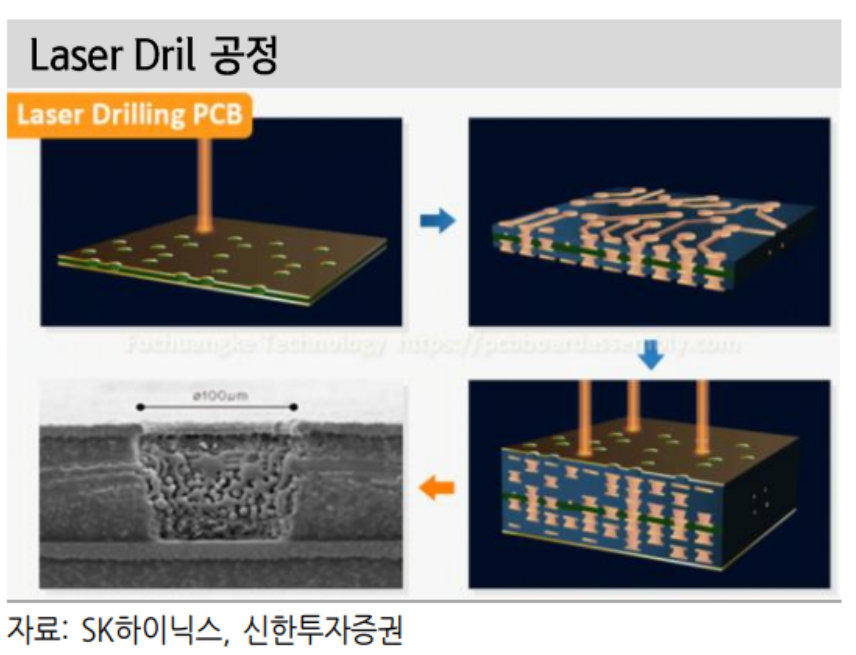
현재 PCB Drill 시장에서 주된 방식인 CO2 Laser는 Via의 크기를 20um 초반까지 밖에 줄이지 못하는 한계가 있다. 하지만 고성능 반도체를 대응하기 위해서는 점점 직경이 작은 Via가 요구되며, 2um 수준까지 축소할 수 있 는 UV Laser 방식에 대한 수요가 점점 더 높아질 것으로 기대된다.
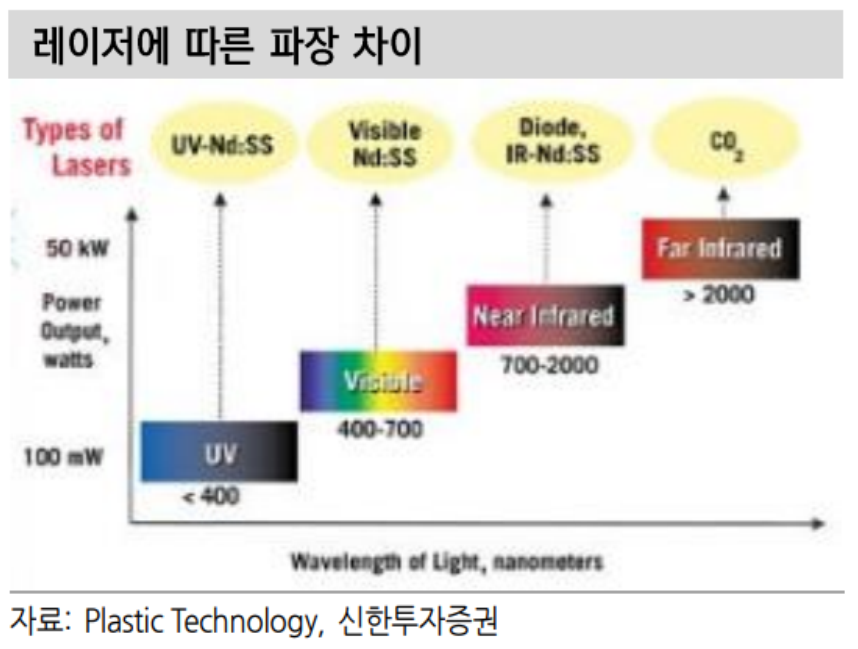
TO-BE continued....
출처: 신한투자증권
뜨리스땅
'반도체, 소.부.장.' 카테고리의 다른 글
| 생성형 AI를 위한 반도체 기술 trend 2/2 - 주요 반도체 기업들의 전략 (0) | 2024.04.15 |
|---|---|
| 생성형 AI를 위한 반도체 기술 trend 1/2 (0) | 2024.04.14 |
| 클라우드 시장의 AI 중심의 재편 (0) | 2024.04.08 |
| 엔비디아(NVIDIA)의 쿠다(CUDA) 지배력은 영원할까? (0) | 2024.03.30 |
| SK하이닉스 - HBM 막차 떠난다 (0) | 2024.03.29 |



댓글