1. 기업 개요 - 반도체 장비 전문업체
1990년에 설립되어, 2019년 전공정 반도체 장비 중심의 피에스케이와 후공정 장비 중심의 피에스케이홀딩스로 인적분할을 진행했다.


2013년 인수한 SEMIgear의 Fluxless Reflow 원천 기술로 후공정에 요구되는 Reflow 장비와 전공정∙후공정에 서 요구되는 Descum 장비를 주력으로 생산하고 있다. 이외에도 웨이퍼 및 기판 세정에 요구되는 HDW(Hot Di Water) 가열장비와 플라즈마 소스를 공급하고 있 다.
2022년 기준 제품 매출 비중은 78%이며, 제품 내 구성은 Descum 45%, Reflow 39%, 플라즈마 소스 10%, HDW 6%다.

전세계적으로 60개 이상의 IDM, 파운드리, OSAT 업체를 고객사로 보유하고 있 다. 2022년 기준 주요 제품의 지역별 매출 비중은 Descum 기준 한국 47%, 중화권 34%, Reflow 기준 한국 28%, 중화권 63%를 차지한다.

2. 주요 제품 - Reflow 장비
리플로우(Reflow) 장비는 솔더 범프에 열을 가하여 범프를 형성할 때 사용하는 장비다.
공정 중에 플럭스를 사용하는지 여부에 따라서 1) 플럭스 리플로우 장비, 2) 플럭스리스 리플로우 장비로 구분하며, 동사는 플럭스리스 리플로우 장비만을 공급 중에 있다.

공정 중에 챔버 내부를 오염시키는 플럭스를 사용하지 않기 때 문에 오염 물질이 발생하지 않는다. 또한 플럭스 도포 및 세정 과정이 요구되지 않아 공정 시간을 단축할 수 있는 장점을 갖고 있다.
기존에 Reflow 장비는 전통적인 PKG(패키지)인 Flip Chip 공정에서 사용됐으며, 도금된 솔더 범프에 열을 가하여 구형으로 만드는 장비다. 이를 통해 1) 본딩 공 정 시 접합성 ↑, 2) 범프 간 높이 차이 최소화, 3) 범프 표면의 거친 정도를 낮추 는데 유리하다.
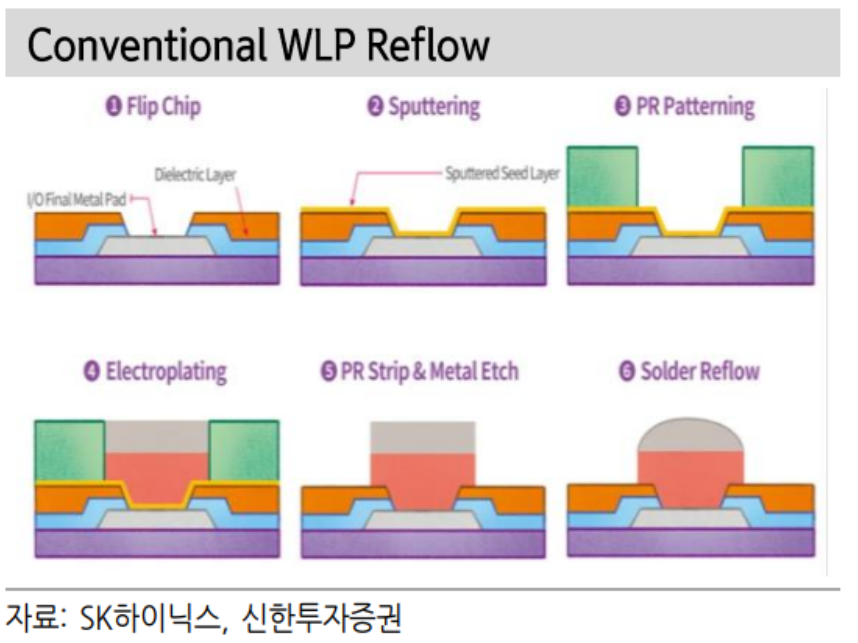
최근 AI반도체 수요 증가와 함께 적층 기술이 적용된 HBM에 대한 수요가 높다. DRAM을 여러 층으로 적층할 때 수직으로 연결된 칩의 정렬이 가장 중요하다. Reflow 장비는 적층 공정에서 TC 본딩 이후 칩에 열을 가하 여 칩을 적절한 위치로 재배치(정렬도 ↑)시키는 역할을 담당한다.

3. Descum 장비
디스컴(Descum) 장비는 반도체 공정 중에서 발생하는 스컴(찌꺼기)을 제거(세정)하는 장비다. 일반적으로 포토 공정 중에 사용되는 PR의 스컴을 제거하는데 많이 사용되고 있어 Fab 투자 확대와 함께 요구되어 왔다. 하지만 식각 공정 중에 발생한 스컴 또한 제거할 수 있는 것으로 판단된다.
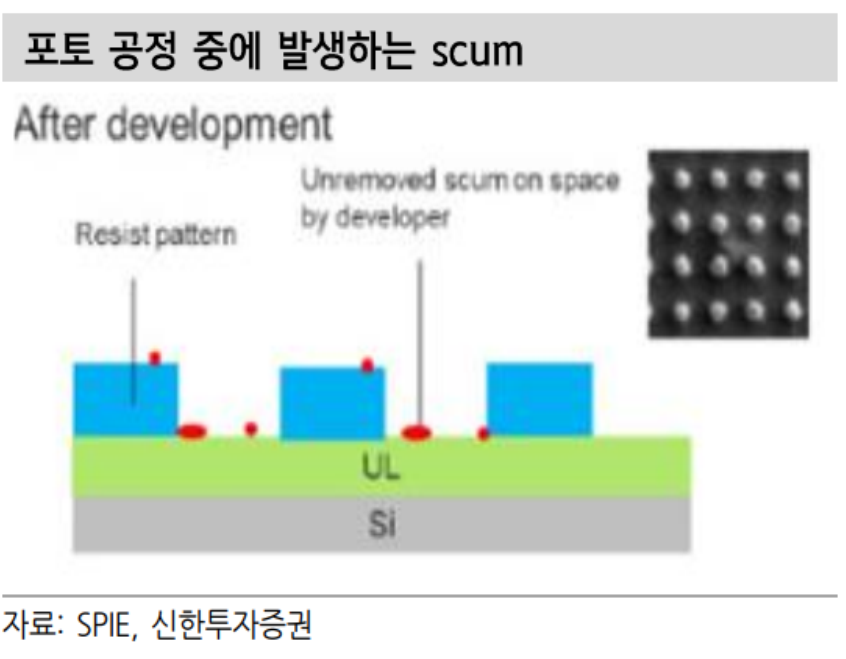

최근 HBM 수요가 급증하고 있고, 칩과 칩을 연결하는 TSV 기술의 중요도가 높아지고 있다. TSV는 칩을 수 직으로 적층하기 위한 기술로, 식각 공정을 이용해 칩에 구멍(Via Hole)을 만들어주는 기술이다. TSV 공정 중에 발생한 스컴을 제거하는데도 활용된다.
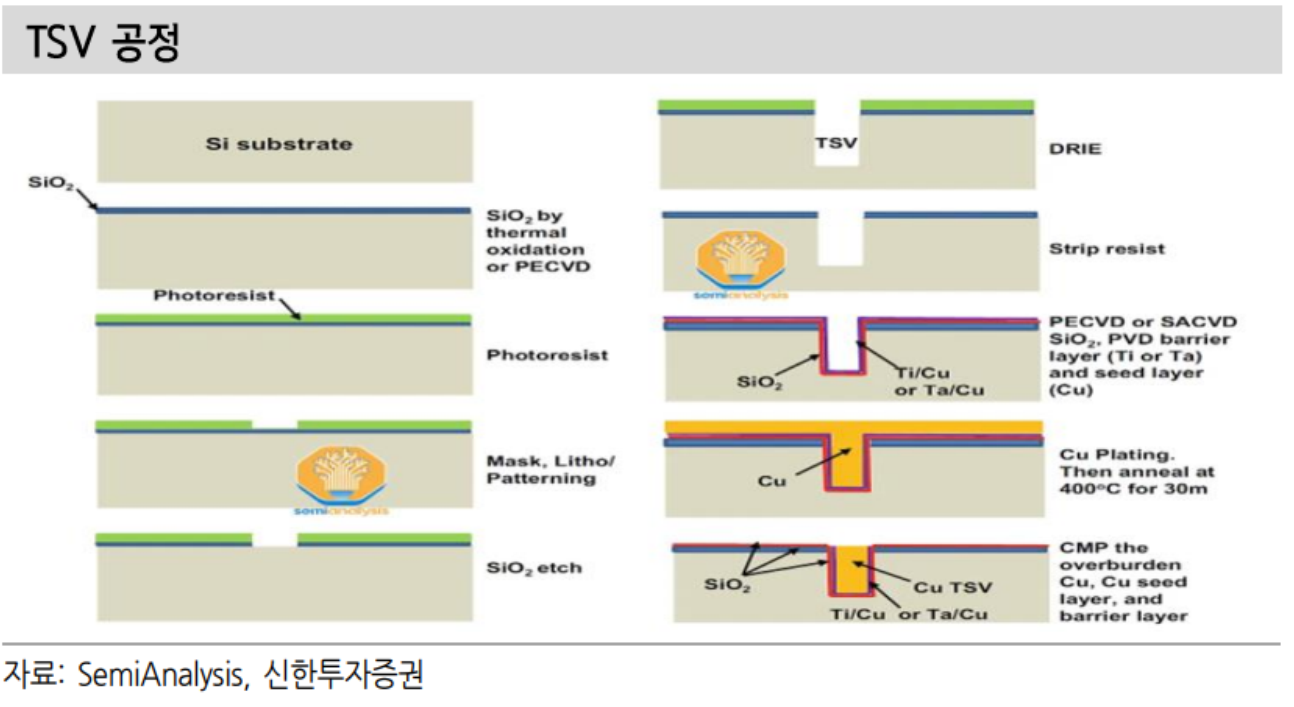
4. 성장 전망
4.1. HBM 수혜 지속 - HBM 부족 상황 지속
AI 수요 증가와 함께 H100과 A100에 필요한 CoWoS(Chip on Wafer on Substrate) Capa는 여전히 수요 대비 부족하다. AI반도체와 함께 패키지되는 HBM 또한 공급 부족 상황이 지속되고 있다. 글로벌 빅테크의 AI 반도체 수요 가 높은 상황에서 CoWoS, HBM 중심의 병목현상이 단기적으로 해소되지 않을 가능성이 높다.
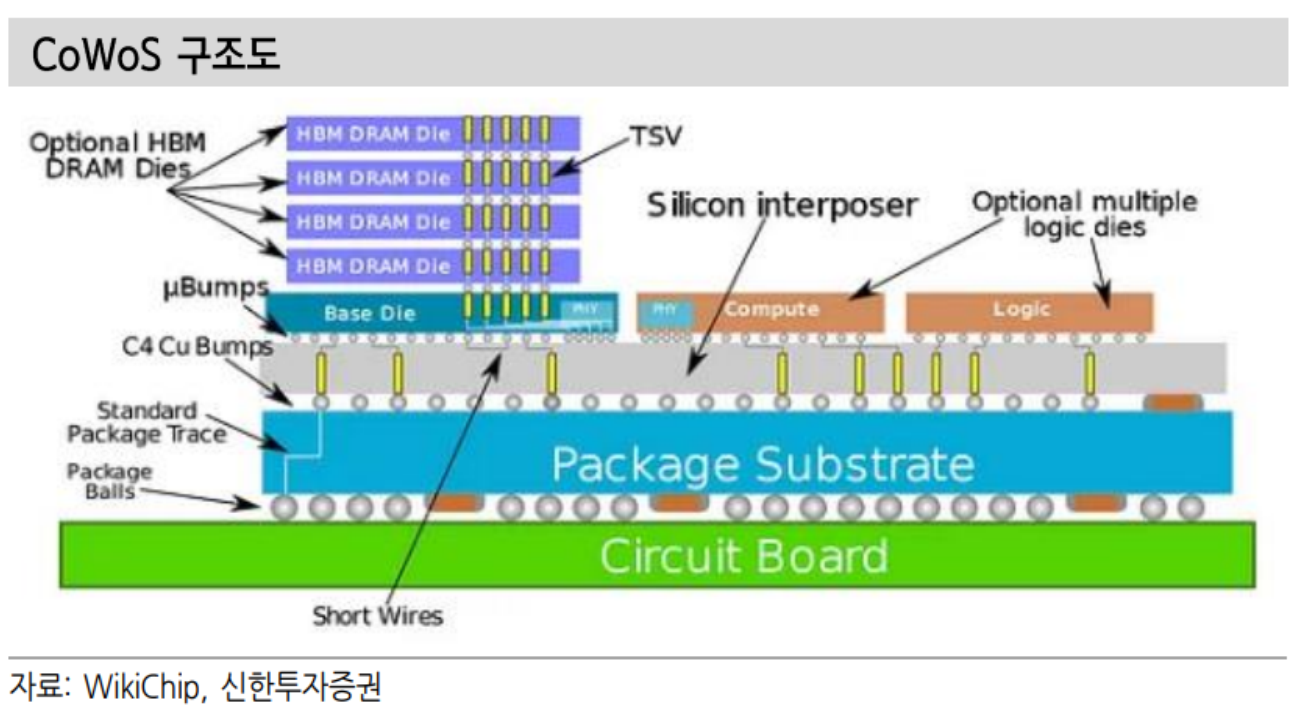
이에 삼성전자, SK하이닉스, 마이크론은 HBM Capa 증설에 적극 적인 모습을 보여주고 있다. 작년 말 기준 삼성전자와 SK하이닉스의 HBM Capa 는 각각 50K/월 수준으로 보인다. 2024년 메모리 생산업체의 CapEx는 HBM에 집중될 예정이며, 올해 말 기준 HBM Capa는 2배 이상으로 확장될 전망이다.


주력으로 생산중인 Reflow 및 Descum 장비 모두 2024년 HBM Capa 증설에 따른 수혜 강도가 높을 것으로 판단된다. HBM을 생산할 때 1) 본딩 공정 시 접합성 ↑, 2) 범프 간 높이 차이 최소화, 3) 범프 표면의 거친 정도를 낮추기 위해 Reflow 장비가 요구된다.
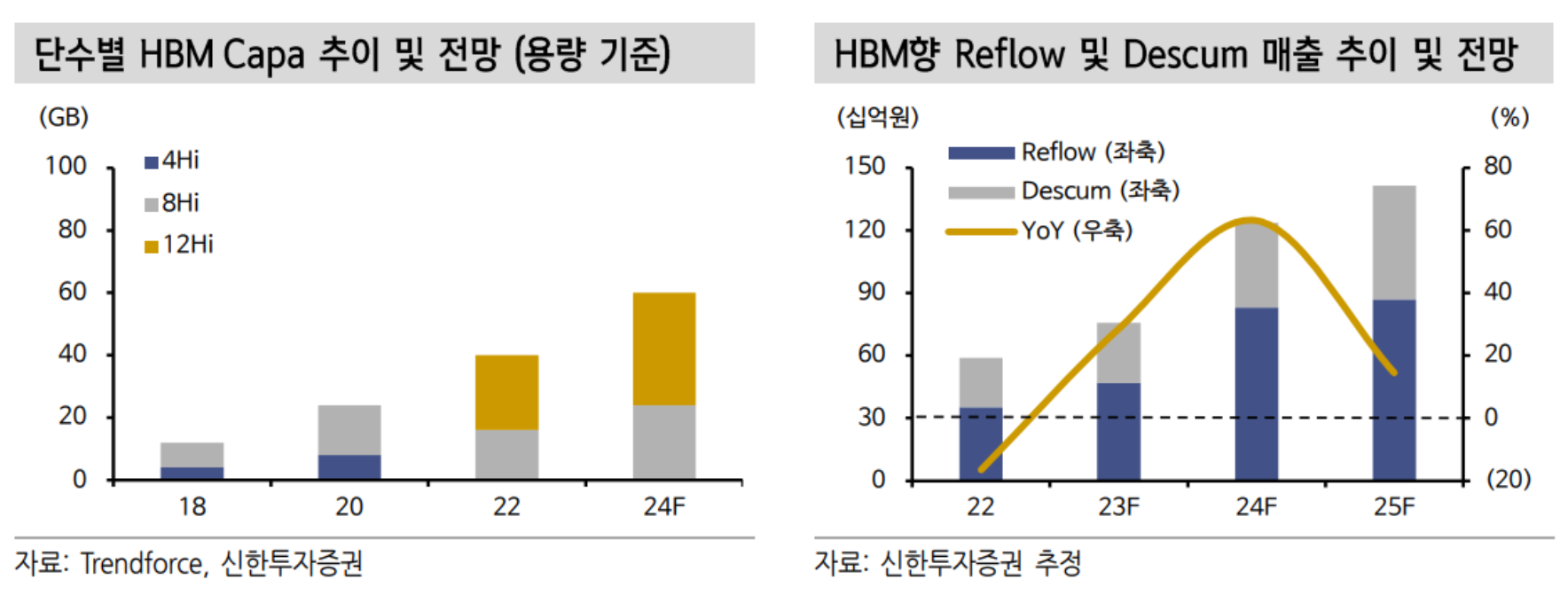
또한 HBM 생산공정 중 칩을 위∙아래로 적층할 때 칩의 전기적 연결을 위해 구멍을 뚫는 TSV 공정이 필수적이다. TSV 공정 중에 발 생하는 찌꺼기(파티클)를 제거하는데 Descum 장비가 활용된다. HBM의 단수가 높아질수록 칩에 형성해야 할 구멍(Via Hole)이 많아지면서 찌꺼기는 더 많이 발생하고, 칩의 두께가 얇아지기 때문에 HBM 수율에 중요한 영향을 미친다.
메모리 생산업체는 2024년 16단의 HBM3e 양산을 계획하고 있다. 이에 Descum 장 비의 수요가 구조적으로 증가할 수밖에 없다.
4.2. 반도체 사이클 회복에 따라, 24년 하반기 전공정 투자 가능성 증대
전방 산업의 수요 부진으로 2H22 반도체 하락 Cycle에 진입한 이후, 2023년 메 모리 생산업체 3사는 강도 높은 공급 조절(가동률 하향, DDR5 전환, Migration) 을 진행했다. 이에 2H23부터 수급 환경의 변화(초과공급 → 공급부족)가 나타나기 시작했다.

메모리 생산업체의 재고는 여전히 높은 수준이지만, 3Q23부터 일부 감소하는 모습이 확인되고 있다. 메모리 반도체 현물가를 보더라도, 10월이 돼서야 DRAM 및 NAND 모두 상승세로 전환횄다.
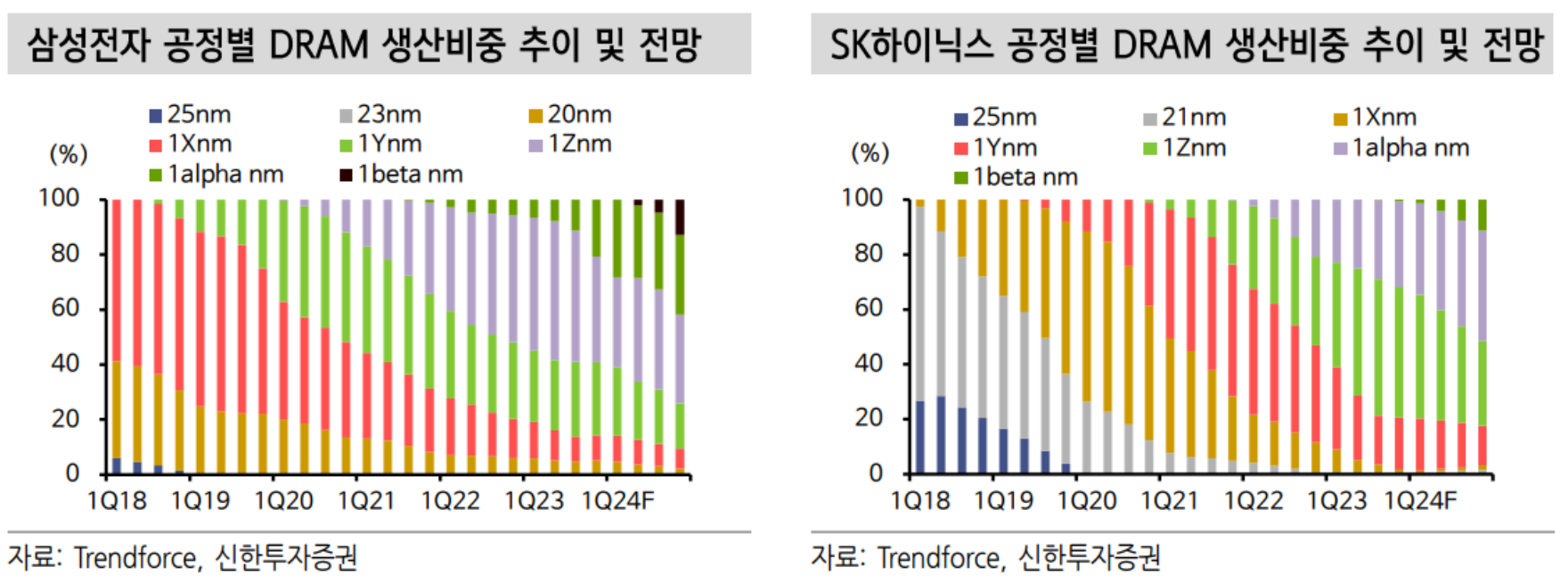
공급자 중심의 우호적인 시장 환경에 따라 2024년 공급 부족은 지속될 것으로 보인다. 다만 2024년에도 메모리 CapEx는 Capa 증설보다는 전환투자에 집중될 예정이다.

이에 향후 Capa loss 우려에 따른 일부 Wafer Capa 증설이 나타날 전망이다. 전공정 CapEx 집 행으로 포토 공정향 Descum 장비의 공급 확대 가능성도 긍정적이다.

출처: 신한투자증권, Trendforce, SemiAnalysis, Semantic Scholor
뜨리스땅
https://tristanchoi.tistory.com/277
반도체 기술 탐구: 차세대 패키지 기술 종합 2 - 인터포저
1. 인터포저의 정의 인터포저(Interposer)는 복수 칩 결합을 위해 사용되는 패키지 기술 중 하나로, 피치(Pitch) 차이가 큰 반도체 칩(Semiconductor Chip)과 기판(Substrate)를 전기적으로 연결하기 위해 삽입
tristanchoi.tistory.com
'반도체, 소.부.장.' 카테고리의 다른 글
| AI 반도체 기술 - 칩렛(Chiplet)의 중요성 (1) | 2024.03.14 |
|---|---|
| NVIDIA(엔비디아) GTC 2024 주요 관전 포인트 (0) | 2024.03.11 |
| 온디바이스 AI: NPU 시장을 견인하다 (0) | 2024.02.29 |
| CUDA: 소프트웨어 때문에 하드웨어를 못 바꾸나? (0) | 2024.02.28 |
| NVIDIA GPU의 Core 구조: CUDA Core와 Tensor Core (1) | 2024.02.28 |




댓글